- 07/21
- 2025
-
QQ扫一扫

-
Vision小助手
(CMVU)
什么是划片?
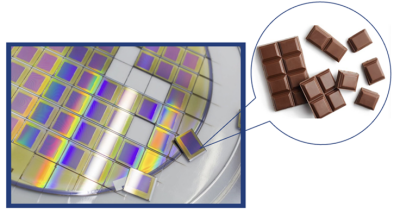
Wafer dicing(晶圆切割)是半导体制造流程中的一个关键步骤,指的是将一个完成芯片制造的整片晶圆(wafer)切割成一个个单独的芯片(die)的过程。这一步通常是在晶圆上的所有电路图形都制作完成、并且通过了测试之后进行。切割方法以自动化执行来保证精度与准确性,切割后的单个裸晶用于后续工序,最后构建在电子设备中。
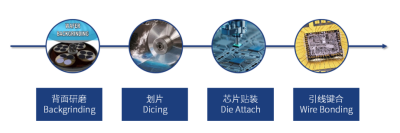
首先,标准半导体制造采用“减薄后切割”方法。晶圆在切割前会被称为背面研磨(back side grinding)的工艺打薄到几十μm的厚度,贴在专用的Dicing Tape上并固定在切割环(Frame)上从而降低了在后续的过程中的机械应力导致晶圆破裂的风险。在切割后使用自动pick-and-place系统将die拾取封装,安装在各种电子设备中发挥它的作用。
机器视觉任务
为确保切割精度、保护良品率、提升自动化水平;用于避免偏切、误切、切到有效芯片区域,在Dicing工艺中机器视觉的关键任务为:自动识别晶圆上切割道或网格线的位置;有时还需根据Die的标记(如晶圆ID、对准标记、图案对称性)确定旋转角度和坐标原点。
而在此过程中,需要获取清晰明暗对比强烈的工件表面、镭射痕迹与刀痕图像。由两套固定倍率的镜头组成的视觉系统进行切换。低倍与高倍系统在工作中“先看全局、再看细节”,每种倍率在流程中承担明确分工。

对镜头与光源的挑战

1.防水雾与飞溅:切割过程中有高压去离子水冷却与微粒飞溅,伴随雾化液滴极易污染镜头与光源,要求从结构上光源与镜头具备防护设计;
2. 结构紧凑:刀头周边空间紧凑,需在刀头、吸嘴、吹气嘴间集成视觉模块;
3. 镜头成像一致性高:定位精度需达到微米级,倍率切换,单支镜头与批量多支镜头差异不能影响图像测量精度;
4. 低角度分区照明环光:切割道往往反差不明显,需强化边缘对比且避免反光干扰。
解决方案
使用 REL07519C / REL7519C 镜头搭配 RELW40 环形光源,可在 Dicing 应用中有效应对关键成像挑战,优势如下:

